您目前所在的位置:首页 > 新闻及活动 > 新闻
2024-04-15
产品动态 | 全自动晶圆缺陷检查系统
来源: 作者: 浏览:676
在集成电路生产过程中,晶圆尺寸越来越大,芯片却越来越小,工艺越来越复杂,在生产过程会给晶圆引入各种表面缺陷。为了减少不必要的损耗,芯片在切片前要进行检查,剔除有缺陷的芯片。本系统专用于切片前有图案晶圆的缺陷检查,为改进制造工艺提高良品率提供数据支持。
徕卡DM8000/12000搭配软件,实现全自动分析
系统高度集成徕卡半导体显微镜DM8000/12000、摄像机、电动扫描台等硬件设备;具备项目化管理、流程化操作等优势,用于芯片切片前人工晶圆缺陷检查。
Standard Wafer Map设置
系统支持用户自行定义Wafer检查模板,也可按用户要求定制开发专用的模板文件读取接口。配合电动台支持从4寸到12寸晶圆的检查。Wafer Map规格可以从以下方式定义:
a. 按输入的Die的宽高间距定义;
b. 从Excel文件读取;
c. Tokyo Seimitsu Map (Custom Develop)
d.STMicroelectronics Map (Custom Develop)

设置Wafer上的待检Dies。支持全检模式、按模板均匀分布、用户自选等三种模式。
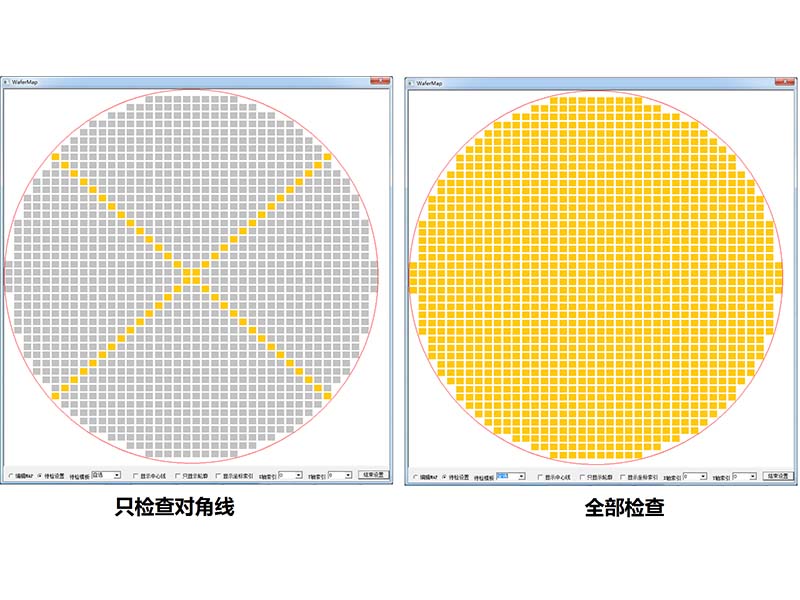
设定Sub Die支持全检模式或自定位置两种模式,满足用户对不同芯片检查的需要。检查时系统将按用户设定的Sub Die 位置移动扫描台。

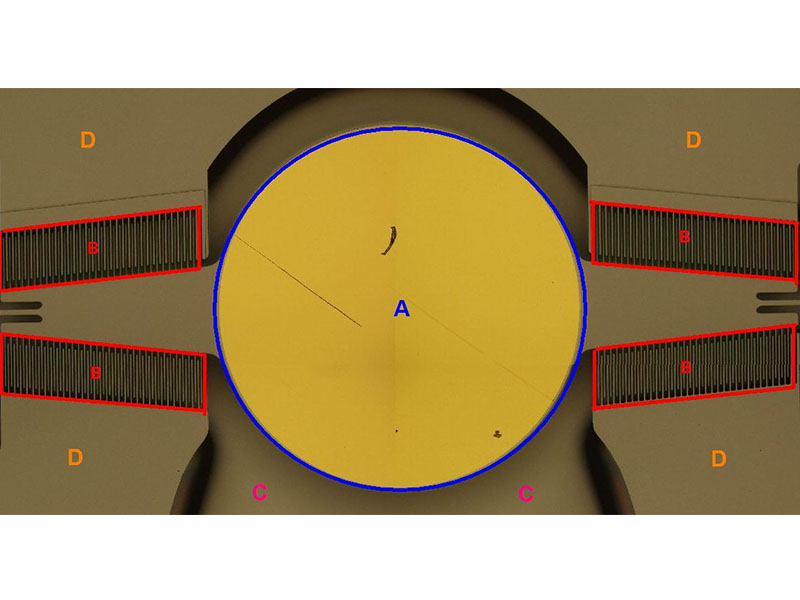
用户可自行增加Defect Code代码以及对应名称,用于评价Sub Die 和 Die的缺陷情况。其中Bin Code 可设置相应的颜色用于表征Map上的分布。

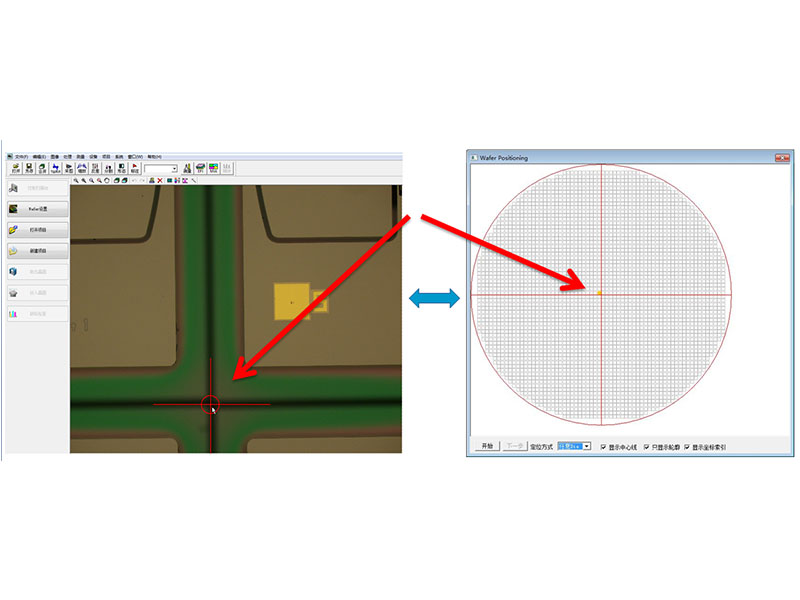
1) Wafer Position:支持单点、双点、三点定位。可满足不同大小晶圆上对Die的准确定位。
2) Inspection:可选手动移位检查和自动移位检查两种模式。选择自动移位时系统将自动按设定的Sub Die进行走位,用户只需观察屏幕即可完成检查。
3) Snap Images:抓拍缺陷图像,并选择Defect Code,系统支持快捷键抓拍并确定缺陷代码。
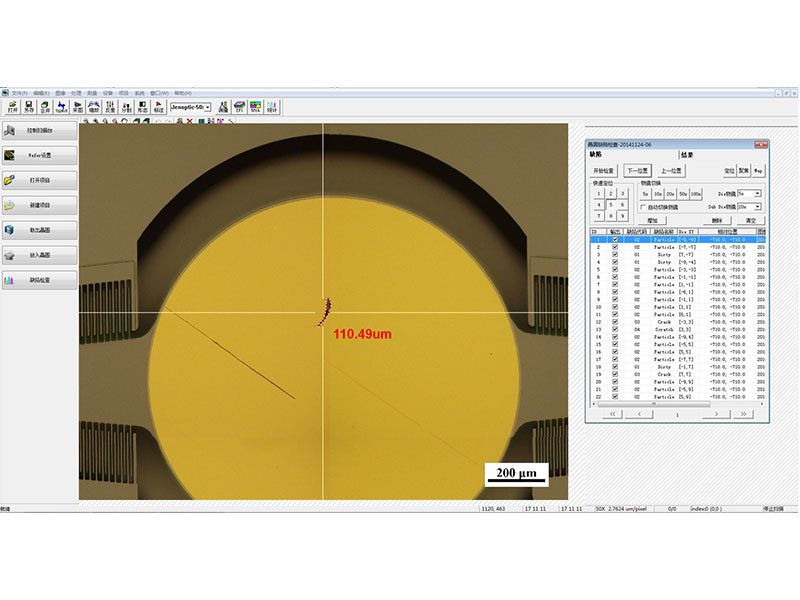

1) Map 图:按用户设定的Bin Color显示在Map上,更直观看到Die的合格情况。
2) Map Data:可将结果按用户的要求生成不同的标准接口文件,便于后端设备读取使用。接口文件支持txt、xls、ST map、TSK map等数据格式。
3) Report:报告中包含待检数量、合格数量、合格率等数据,缺陷图像也随同报告一同输出用于长期存档。

上一篇:应用案例 | 金刚石粉末的研磨与粒度粒形分析
下一篇:领拓竞赛 | 2024第一届莱驰产品销售PK赛成功举办



